Dieses Verfahren ermöglicht es, sehr präzise sehr dünne Schichten, quasi Atomlage für Atomlage nacheinander, abzuscheiden (Atomic Layer Deposition). Dafür wird ein zyklischer Prozess durchgeführt und, je nach gewünschter Zieldicke, mehrfach nacheinander durchgeführt.
mehr Details
Mit Hilfe der Atomlagenabscheidung (Atomic Layer Deposition, ALD) ist es möglich, sehr dünne Schichten - quasi Atomlage für Atomlage einzeln - dielektrischer, metallischer oder halbleitender Materialien bei niedrigen Temperaturen abzuscheiden. Die größten Vorteile liegen vor allem in der extrem konformalen und sehr kontrollierbaren Abscheidung stöchiometrischer Dünnschichten. Das erlaubt auch sterisch anspruchsvolle Substrate, wie poröse oder strukturierte Materialien, gleichmäßig zu beschichten Die Einleitung der Ausgangsstoffe (sog. Precursor), die als Dampf oder Gas in die Vakuumkammer gelangen, ist zeitlich durch Inertgas-Spülvorgänge getrennt. So findet jeweils nur die chemische Reaktion einer molekularen Monolage auf der Oberfläche der Probe statt. Bei der thermischen ALD erfolgt die Chemisorption und Reaktion mit Hilfe thermischer Energie, wofür oft geringe Temperaturen im Bereich von 50 – 300 °C ausreichen. Alterantiv kann in speziellen Anlagen plasmaunterstütze ALD (engl. Plasma Enhanced Atomic Layer Deposition, PE-ALD) durchgeführt werden. Hier geschieht die Reaktion mit plasma-dissozierten Reaktanden (Radikalen). Die Schichtdicke wird durch die Anzahl der Zyklen bestimmt und die chemische Zusammensetzung durch die Kombination der Reaktanden. Einige im Reinraumlabor etablierte Prozesse sind die Abscheidung von Al2O3, ZnO, TiO2, ZrO2, In2O3 und die Herstellung von ternären Mischoxiden wie TiAlOx .
Thermische Atomlagenabscheidung
Die Reaktanden werden nacheinander in die geheizte Prozesskammer eingeleitet und führen dort zur Abscheidung der gewünschten Schicht.
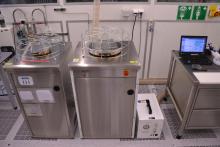
Savannah ALD
Cambridge NanoTech Savannah 200
- Thermische ALD bis 350°C
- Wafer-Durchmesser bis 200 mm
- 4 beheizbare Precursor-Ports
- Gase: N2, O3 (Ozon)
Cambridge NanoTech Savannah 100
- Thermische ALD bis 400°C
- Wafer-Durchmesser bis 100 mm
- 3 beheizbare Precursor-Ports
- Gase: N2, O2
Beneq-ALD
Hier können Abscheidungen rein thermisch, aber auch mit Plasmaunterstützung durchgeführt werden.
Beneq R2 PEALD
- Thermische ALD bis 400°C
- Plasma-ALD bis 250°C mit 300 W RF-Plasma (kapazitiv gekoppelt, direkt oder remote)
- Plasmagase: O2, N2, Ar
- Wafer-Durchmesser bis 200 mm
- 2 beheizbare Precursor-Ports
- 4 Precursor-Ports bei Raumtemperatur
- Gase: N2, Ar, O2, H2
Plasmaunterstützte Atomlagenabscheidung
Diese Anlage ist Teil eines Abscheideclusters. Hier ist rein thermische Abscheidung, aber auch mit Unterstützung durch ein kapazitiv gekoppeltes Plasma möglich. Durch ein Ellipsometer lässt sich die Abscheidung in situ verfolgen und optimieren.
mehr Details
Für plasmaunterstützte Abscheideprozesse nutzen wir eine Anlage der Firma Sentech. Sie verfügt über je ein Modul zur plasmaunterstützten Atomlagenabscheidung (PE-ALD), plasmaunterstützten chemischen Gasphasenabscheidung (PE-CVD (Chemical Vapor Deposition)) und zur plasmaunterstützten Atomlagenätzung (PE-ALE (Atomic Layer Etching)). Ein Vorteil des Clusters ist die Möglichkeit, Proben in verschiedenen Modulen nacheinander zu prozessierten, ohne sie zwischenzeitlich aus dem Hochvakuum auszuschleusen.
Mit dem PE-ALD-Modul sind auch rein thermische Prozesse (ohne Plasma) durchführbar.
- Abscheidetemperaturen: bis 500 °C
- Plasmaleistung bis 200 W, Gaseinlass über einen Showerhead
- Reaktionsgase: O2, O3, N2, NH3, H2
- Wafer-Durchmesser bis 150 mm
- 6 beheizbare Precursor-Ports, 4 bubblebar (bis 165°C)
- In-situ Metrologie: Laserellipsometrie (RTM)
Der Realtime-Monitor (RTM) ist ein Ellipsometer, mit dem die Abscheidung während der einzelnen Zyklen verfolgt werden kann. Damit ist eine in situ Überwachung möglich und optimale Prozessfenster lassen sich schnell ermitteln.